前言
对于生产加工过程而言,能否控制好加工过程循环是生产的关键,这一点对于要求非常高的半导体加工过程来说更是如此。半导体加工通常十分复杂,需要控制很多的参数。由于半导体的材质具有易碎的特点,需借助专用机床完成切片、研磨、减薄、测试、划片和封装。因此,在有电路和无电路的晶圆上检测缺陷,并提高和保持高产良品率十分必要。
马波斯:您的计量和检验合作伙伴
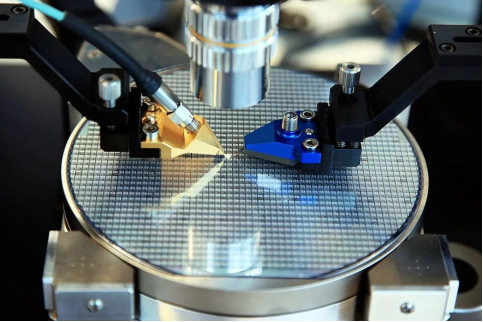
在晶圆制造的后道工序,工程师们需要改进晶圆制造的自动化步骤。马波斯为切片机和研磨机、减薄机和划片机、TTV、翘曲、多层、刻蚀槽测量提供接触和非接触式测量传感器。
对于半导体行业来说,未来将会生产更小的器件,这些器件的形状和材料都将会更加复杂。为此,马波斯拥有一整套用于蓝膜测量、晶圆尺寸、晶圆检验和封装检验的非接触式传感器。
控制晶圆厚度,监控晶圆研磨机

对于由硅、蓝宝石、砷化镓、碳化硅等材料制成的晶圆,需要高精度的表面加工技术。所有直径晶圆的研磨、背磨机械和化学抛光机必须提供很高的工艺要求,以确定工序或全部工序测量的要求。
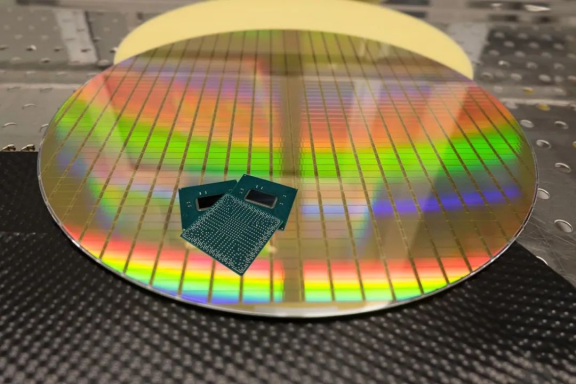
这是一个特别关键的过程,需要用不同工艺和专业设备严格控制晶圆的厚度变化。马波斯非接触红外传感器 NCG,能在这一重要工艺加工过程和后续加工中控制晶圆的厚度。这有助于晶圆在无损伤影响的情况下还保持工艺可控。
控制晶圆厚度,监控硅片背磨机
在半导体制造中,在封装前获得准确的晶圆厚度是至关重要的。晶圆背磨(或称晶圆减薄)是半导体制造工艺的一序,旨在控制晶圆厚度,这对于生产紧凑型电子设备中制造多层和高密度封装的超薄晶圆是必要步骤。
晶圆减薄一直是关键的加工工艺。电路已经存在于晶圆上,工艺中的任何问题都会影响生产的产量和成本。即使在有去离子水的情况下,也可以使用接触式传感器或非接触式传感器来严格控制晶圆减薄过程中的控制。
半导体制造检测的光学设计

除了晶圆厚度控制,半导体制造过程中的缺陷检测也是至关重要的。马波斯STIL光谱共聚焦技术是高精度外观和缺陷测量的理想解决方案。光学笔可提供不同的景深测量距离、测量范围、光斑大小和数值孔径,以更好地适应应用要求。干涉(红外和白光)产品也可用于检测透明和非透明材料的厚度的精确测量。
推荐阅读:旗龙
查看心情排行你看到此篇文章的感受是: